Литография высокого разрешения в технологии полупроводниковСтраница 8
1) серебряная эмульсия;
2) обработанный ионами резист;
3) диазидные полимеры;
4) оксид железа;
5) германий на стекле;
6) хром на стекле;
7) отожженный полиакрилонитрил;
8) оксид европия.
Изготовление рабочих (1х) фотошаблонов осуществляется фото-повторением промежуточного (10х) фотошаблона на прецизионном координатном столе. Точность подачи координатного стола чрезвычайно важна для достижения точного совмещения при фотоповторении. Необходимо отметить также важность точного совмещения промежуточного фотошаблона для предотвращения разворота рисунков отдельных кристаллов относительно друг друга на рабочих фотошаблонах.
Перспективы развития фотолитографии.
Никакие другие системы экспонирования не могут соперничать с оптическими системами в производительности и высокой стабильности шаблонов. Развитие техники экспонирования от контактной печати и печати с зазором к проекционной фотолитографии обусловлено необходимостью снижению износа шаблонов, ведущего к дефектности, и обеспечения требуемой точности совмещения. Для того, чтобы снизить себестоимость СБИС с субмикронными размерами элементов, необходимо увеличить размер рабочего поля степперов, точность глобального совмещения сканеров и плоскостность поверхностей пластин после высокотемпературных процессов. Если число разрешаемых элементов внутри отдельного кристалла (>108) превосходит предел, определяемый глубиной фокуса, то поле каждого кристалла может быть разбито на более мелкие подобласти (для компенсации большей числовой апертуры) так, как это делается в системах пошагового экспонирования. По мере ужесточения допусков при производстве новых приборов потребуется дальнейшее совершенствование систем совмещения.
Внутренние и взаимные эффекты близости являются главными проблемами систем фотолитографии. Дифракционные и интерферен-ционные эффекты искажают структуры, воспроизводимые поверх уже сформированного рельефа. Высококонтрастный однослойный ДУФ резист способен значительно улучшить контроль размеров элементов и ослабить требования на технологические допуски. Используемый в субмикронной литографии процесс переноса изображения в поверхностный слой резиста или другого сильнопоглощающего материала нуждается в дальнейшем совершенствовании. Проблема поверхностного переноса изображения заключается в том, что нужно сделать толщину резистного слоя всего несколько нанометров. При этом можно будет использовать установки экспонирования с низкой оптической МПФ. Резисты, обладающие высокой чувствительностью (порядка 1 мДж/см2), позволили бы применять метод экспонирования типа “вспышка на лету” для существенно меньших полей и поставить производительность процесса в зависимость только от времени глобального совмещения и шага.
Существует ряд приборов, которые могут быть изготовлены только с помощью УФ литографии, поскольку применение высокоэнергетичных электронных пучков или рентгеновских лучей может нанести этим приборам необратимые повреждения. Фотолитография, как таковая, останется основным инструментом при массовом производстве СБИС.
Электронно-лучевое экспонирование.
Введение.
В традиционной фотолитографии резисты экспонируются незаряженными фотонами ультрафиолетового диапазона. Из теории дифракции и практической микроскопии известно, что разрешение ограниченно длинной волны используемого излучения. При использовании некоторых видов излучения высокой энергии шаблоны могут не применятся, что ведет, с одной стороны, к снятию ограничения по разрешению, с другой к снижению производительности процесса экспонирования и росту производственных затрат.
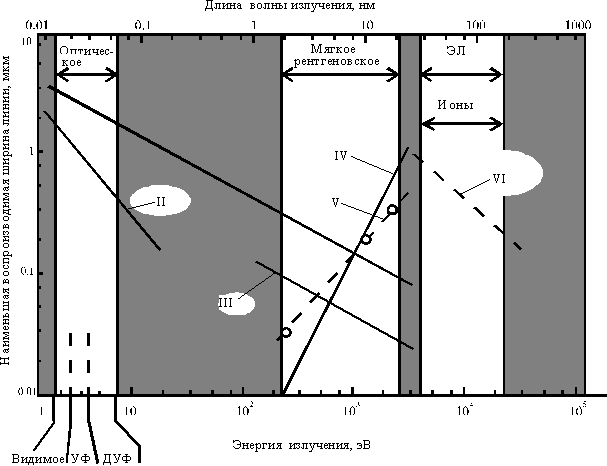
Рис. 11. Наименьшая воспроизводимая ширина линии : I - дифракционный предел (зазор 10 мкм); II - дифракционный предел (NA объектива равна 0.4); III - дифракционный предел (зазор 1 мкм); IV и V - предел рассеяния фотоэлектронов, теоретические значения и данные эксперимента соответственно; VI - предел, определяемый обратным рассеянием электронов.
