Безкорпусная герметизация полупроводниковых приборовСтраница 22
Реакция взаимодействия SiH4 и N2H4. Вместо аммиака для получения плёнок Si3N4 может быть использован гидразин N2H4.
При использовании аммиака температура осаждения пленок нитрида кремния не может быть 750С . Применение гидразина позволяет снизить температуру до 500С, так как гидразин разлагается при более низких температурах, чем аммиак. Наносят плёнки в кварцевой трубе, через которую пропускается водород, насыщенный гидразином. В эту смесь добавляют SiH4. Концентрацию SiH4 и N2H4 можно выбирать в пределах от 1:0,5 до 1:10. Скорость подачи газовой смеси в рабочую камеру 0,6 л/мин. Перед проведением процесса гидразин очищают при комнатной температуре. На рис показана зависимость скорости роста плёнок нитрида кремния от температуры для трёх различных концентраций гидразина. Скорость осаждения плёнок Si3N4 начиная с температуры750С остаётся постоянной, а при больших концентрациях гидразина и температурах выше 1000С уменьшается.
Реакция взаимодействия SiBr4 и N2. Этот метод основан на реакции взаимодействия между азотом и тетрабромидом кремния. Одним из основных требований при получении пленки Si3N4 является предотвращении возможности образовании в ней двуокиси кремния. Для этого азот перед смешиванием с тетрабромидом кремния тщательно очищают от кислорода. Получают пленку Si3 N4 при температуре 9600 С. Скорость подачи реакционной смеси устанавливают равной 100мл\мин. В течении часа на подложке осаждается пленка толщиной 10 мкм. На рисунке 39 показана схема установки для получения пленок нитрида кремния.
Реактивное катодное распыление. При этом методе реакция между кремнием и азотом происходит при низкой температуре окружающей среды с помощью электрического разряда. Наносят защитные пленки нитрида кремния в установках катодного распыления на постоянном токе с холодным или горячим катодом. Качество пленок, получаемых этим методом, изменяется в зависимости от условий осаждения. Для проведения процесса используют катод из высокочистого кремния в виде плоской пластины большого диаметра. Этот катод распыляют в смеси аргона и азота. Азот является реактивным газом, а аргон используют для повышения эффективности распыления. Кремний взаимодействует с кислородом лучше, чем с азотом, поэтому даже незначительное количество кислорода в рабочих газах (N2 и Ar) приводит к образованию пленки окиси кремния SiO2 на поверхности полупроводника. Обычно для катодного распыления используют рабочие газы, прошедшие предварительную очистку от кислорода. Получение защитных пленок Si3N4 проводят при давлениях в камере от 6,6*10*до 26 Па. Напряжение распыления может быть выбрано от 600 до 2500В, а катодный ток-0,2*0,8мА\см2. Скорость роста пленки 10 нм\мин. Применение катода с большей поверхностью позволяет получать пленки одинаковой толщины(с разбросом, не превышающим 5%) одновременно на большом количестве пластин или кристаллов.
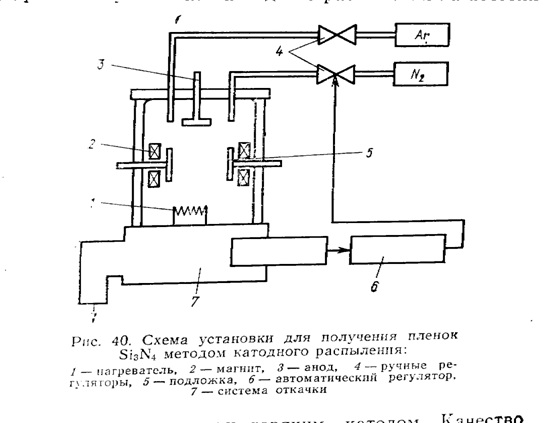
Высокочастотное реактивное распыление. Высокочастотное реактивное распыление защитных пленок Si3N4 обладает рядом преимуществ: скорость по сравнению с катодным распылением выше, а эффект бомбардировки отрицательными частицами меньше. Кроме того, пленки, полученные в высококачественном разряде, менее чувствительны к присутствию в рабочей камере следов кислорода. Скорость осаждения при этом методе пропорциональна мощности высокочастотного разряда и увеличивается с уменьшением расстояния между мишенью и полупроводниковым кристаллом. Для создания плазмы внутри рабочей камеры используют азот. Ионы азота, ударяясь о кремниевую мишень, распыляют кремний. Атомы кремния, вылетевшие из мишени, вступают в реакцию с азотом. В результате этой реакции образуется нитрид кремния, который осаждается на полупроводниковом кристалле (подложке). Оптимальное давление азота в рабочей камере 1,3 – 0,13 Па.
